Ah, tous ces fils de puce !
sur
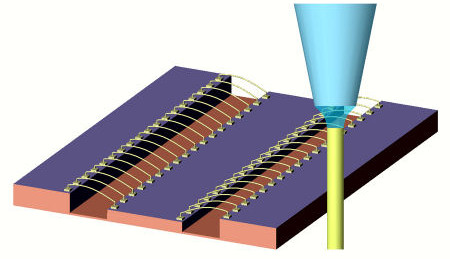
Des chercheurs de l'Université de l'Illinois ont développé une nouvelle technique pour connecter une puce à son environnement. Celle-ci permet d’« écrire » les fils de connexion (wire bonds) « en l'air ». Les fils obtenus avec cette technique sont beaucoup plus minces que les fils utilisés normalement. Ainsi la surface des contacts peut être réduite et par conséquent leur nombre peut être augmenté.
Une solution électrolytique de cuivre est contenue dans une micropipette dont l'extémité est placée à proximité de la surface de contact : un pont liquide se forme entre la bouche de la pipette et la zone de contact. Quand les chercheurs font circuler un courant électrique à travers ce pont liquide, le cuivre dissous dans le pont se solidifie. Même quand la pipette est éloignée (progressivement) de la surface de contact, le cuivre reste solidifé, un fil s'est formé !
Dans un processus de fabrication automatisée, une grille de pipettes pourra être utilisée, afin de réaliser simultanément des dizaines voire des centaines de connexions de ce genre.
Outre la réalisation de connexions dans les circuits intégrés, la technique se prête également à la réalisation de microstructures en métal.


Discussion (0 commentaire(s))